Iako i silicijske i staklene pločice dijele zajednički cilj "čišćenja", izazovi i načini kvarova s kojima se suočavaju tijekom čišćenja uvelike se razlikuju. Ova razlika proizlazi iz inherentnih svojstava materijala i zahtjeva specifikacija silicija i stakla, kao i iz različite "filozofije" čišćenja vođene njihovim konačnim primjenama.
Prvo, razjasnimo: Što točno čistimo? O kojim se onečišćujućim tvarima radi?
Kontaminanti se mogu podijeliti u četiri kategorije:
-
Čestice zagađivača
-
Prašina, metalne čestice, organske čestice, abrazivne čestice (iz CMP procesa) itd.
-
Ovi zagađivači mogu uzrokovati nedostatke u uzorku, poput kratkih spojeva ili otvorenih strujnih krugova.
-
-
Organski kontaminanti
-
Uključuje ostatke fotorezista, aditive smole, ulja ljudske kože, ostatke otapala itd.
-
Organski onečišćivači mogu stvarati maske koje ometaju jetkanje ili implantaciju iona i smanjuju prianjanje drugih tankih filmova.
-
-
Kontaminanti metalnih iona
-
Željezo, bakar, natrij, kalij, kalcij itd., koji prvenstveno potječu iz opreme, kemikalija i ljudskog kontakta.
-
U poluvodičima, metalni ioni su "ubojiti" kontaminanti, uvodeći energetske razine u zabranjenu zonu, što povećava struju curenja, skraćuje vijek trajanja nosioca naboja i ozbiljno oštećuje električna svojstva. U staklu mogu utjecati na kvalitetu i prianjanje sljedećih tankih filmova.
-
-
Prirodni oksidni sloj
-
Za silicijeve pločice: Tanki sloj silicijevog dioksida (izvorni oksid) prirodno se formira na površini u zraku. Debljinu i ujednačenost ovog oksidnog sloja teško je kontrolirati i mora se potpuno ukloniti tijekom izrade ključnih struktura poput oksida vrata.
-
Za staklene pločice: Samo staklo je mrežasta struktura silicijevog dioksida, tako da nema problema s "uklanjanjem sloja izvornog oksida". Međutim, površina je možda modificirana zbog kontaminacije i taj sloj treba ukloniti.
-

I. Osnovni ciljevi: Razlika između električnih performansi i fizičkog savršenstva
-
Silikonske pločice
-
Glavni cilj čišćenja je osigurati električne performanse. Specifikacije obično uključuju stroge brojeve i veličine čestica (npr. čestice ≥0,1 μm moraju se učinkovito ukloniti), koncentracije metalnih iona (npr. Fe, Cu moraju se kontrolirati na ≤10¹⁰ atoma/cm² ili manje) i razine organskih ostataka. Čak i mikroskopska kontaminacija može dovesti do kratkih spojeva u strujnom krugu, struja curenja ili kvara integriteta oksida vrata.
-
-
Staklene pločice
-
Kao podloge, osnovni zahtjevi su fizička savršenost i kemijska stabilnost. Specifikacije se usredotočuju na makro aspekte kao što su odsutnost ogrebotina, neuklonjivih mrlja i održavanje izvorne hrapavosti i geometrije površine. Cilj čišćenja je prvenstveno osigurati vizualnu čistoću i dobro prianjanje za sljedeće procese poput premazivanja.
-
II. Materijalna priroda: Temeljna razlika između kristalnog i amorfnog
-
Silicij
-
Silicij je kristalni materijal, a na njegovoj površini prirodno raste neujednačen sloj silicijevog dioksida (SiO₂). Ovaj sloj oksida predstavlja rizik za električne performanse i mora se temeljito i ujednačeno ukloniti.
-
-
Staklo
-
Staklo je amorfna mreža silicijevog dioksida. Njegov glavni materijal sličan je sastavu sloju silicijevog oksida silicija, što znači da se može brzo nagrizati fluorovodičnom kiselinom (HF) i također je osjetljiv na jaku alkalnu eroziju, što dovodi do povećanja hrapavosti ili deformacije površine. Ova temeljna razlika diktira da čišćenje silicijskih pločica može tolerirati lagano, kontrolirano nagrizanje radi uklanjanja onečišćenja, dok se čišćenje staklenih pločica mora provoditi s izuzetnim oprezom kako bi se izbjeglo oštećenje osnovnog materijala.
-
| Predmet za čišćenje | Čišćenje silikonskih pločica | Čišćenje staklenih pločica |
|---|---|---|
| Cilj čišćenja | Uključuje vlastiti sloj prirodnog oksida | Odaberite metodu čišćenja: Uklonite onečišćenja uz zaštitu osnovnog materijala |
| Standardno čišćenje RCA | - SPM(H₂SO₄/H₂O₂): Uklanja organske/fotorezistne ostatke | Glavni tok čišćenja: |
| - SC1(NH₄OH/H₂O₂/H₂O): Uklanja površinske čestice | Slabo alkalno sredstvo za čišćenjeSadrži aktivne površinski aktivne tvari za uklanjanje organskih onečišćujućih tvari i čestica | |
| - DHF(Fluorovodična kiselina): Uklanja prirodni oksidni sloj i ostale nečistoće | Jako alkalno ili srednje alkalno sredstvo za čišćenjeKoristi se za uklanjanje metalnih ili nehlapljivih onečišćujućih tvari | |
| - SC2(HCl/H₂O₂/H₂O): Uklanja metalne nečistoće | Izbjegavajte HF cijelo vrijeme | |
| Ključne kemikalije | Jake kiseline, jake lužine, oksidirajuća otapala | Slabo alkalno sredstvo za čišćenje, posebno formulirano za uklanjanje blagih nečistoća |
| Fizička pomagala | Deionizirana voda (za ispiranje visoke čistoće) | Ultrazvučno, megasonično pranje |
| Tehnologija sušenja | Megasonic, IPA sušenje parom | Nježno sušenje: Sporo podizanje, sušenje IPA parom |
III. Usporedba otopina za čišćenje
Na temelju gore navedenih ciljeva i karakteristika materijala, otopine za čišćenje silicijskih i staklenih pločica razlikuju se:
| Čišćenje silikonskih pločica | Čišćenje staklenih pločica | |
|---|---|---|
| Cilj čišćenja | Temeljito uklanjanje, uključujući i sloj prirodnog oksida pločice. | Selektivno uklanjanje: uklanjanje onečišćujućih tvari uz zaštitu podloge. |
| Tipičan postupak | Standardno čišćenje RCA:•SPM(H₂SO₄/H₂O₂): uklanja teške organske tvari/fotorezist •SC1(NH₄OH/H₂O₂/H₂O): uklanjanje alkalnih čestica •DHF(razrijeđeni HF): uklanja prirodni oksidni sloj i metale •SC2(HCl/H₂O₂/H₂O): uklanja metalne ione | Karakteristični protok čišćenja:•Blago alkalno sredstvo za čišćenjes površinski aktivnim tvarima za uklanjanje organskih tvari i čestica •Kiselo ili neutralno sredstvo za čišćenjeza uklanjanje metalnih iona i drugih specifičnih onečišćujućih tvari •Izbjegavajte HF tijekom cijelog procesa |
| Ključne kemikalije | Jake kiseline, jaki oksidansi, alkalne otopine | Blago alkalna sredstva za čišćenje; specijalizirana neutralna ili blago kisela sredstva za čišćenje |
| Fizička pomoć | Megasonic (visokoučinkovito, nježno uklanjanje čestica) | Ultrazvučni, megasonični |
| Sušenje | Sušenje marangonija; IPA sušenje na pari | Sušenje sporim povlačenjem; sušenje IPA parom |
-
Postupak čišćenja staklenih pločica
-
Trenutno većina pogona za preradu stakla koristi postupke čišćenja temeljene na materijalnim karakteristikama stakla, oslanjajući se prvenstveno na slabo alkalna sredstva za čišćenje.
-
Karakteristike sredstva za čišćenje:Ova specijalizirana sredstva za čišćenje obično su slabo alkalna, s pH vrijednošću oko 8-9. Obično sadrže surfaktante (npr. alkil polioksietilen eter), kelirajuća sredstva za metale (npr. HEDP) i organska sredstva za čišćenje, namijenjena emulgiranju i razgradnji organskih onečišćujućih tvari poput ulja i otisaka prstiju, a pritom minimalno korozivna za staklenu matricu.
-
Tijek procesa:Tipičan proces čišćenja uključuje korištenje specifične koncentracije slabo alkalnih sredstava za čišćenje na temperaturama u rasponu od sobne temperature do 60°C, u kombinaciji s ultrazvučnim čišćenjem. Nakon čišćenja, pločice prolaze kroz više koraka ispiranja čistom vodom i blagog sušenja (npr. sporo podizanje ili sušenje IPA parom). Ovaj proces učinkovito zadovoljava zahtjeve staklenih pločica za vizualnu čistoću i opću čistoću.
-
-
Postupak čišćenja silicijskih pločica
-
Za obradu poluvodiča, silicijeve pločice obično prolaze standardno RCA čišćenje, što je vrlo učinkovita metoda čišćenja sposobna sustavno uklanjati sve vrste onečišćujućih tvari, osiguravajući ispunjavanje zahtjeva električnih performansi za poluvodičke uređaje.
-
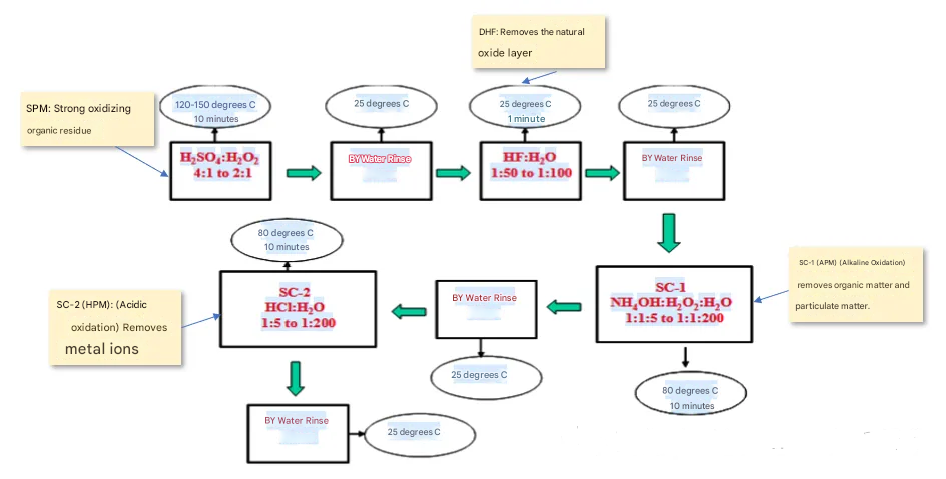
IV. Kada staklo zadovoljava više standarde „čistoće“
Kada se staklene pločice koriste u primjenama koje zahtijevaju strog broj čestica i razine metalnih iona (npr. kao supstrati u poluvodičkim procesima ili za izvrsne površine za taloženje tankih filmova), intrinzični proces čišćenja možda više nije dovoljan. U tom slučaju mogu se primijeniti principi čišćenja poluvodiča, uvodeći modificiranu strategiju čišćenja RCA.
Srž ove strategije je razrjeđivanje i optimizacija standardnih parametara RCA procesa kako bi se prilagodila osjetljivoj prirodi stakla:
-
Uklanjanje organskih onečišćujućih tvari:SPM otopine ili blaža ozonska voda mogu se koristiti za razgradnju organskih onečišćujućih tvari snažnom oksidacijom.
-
Uklanjanje čestica:Visoko razrijeđena otopina SC1 koristi se na nižim temperaturama i kraćim vremenima obrade kako bi se iskoristilo njezino elektrostatičko odbijanje i učinci mikronagrizanja za uklanjanje čestica, a istovremeno se minimalizira korozija stakla.
-
Uklanjanje metalnih iona:Za uklanjanje metalnih onečišćenja kelacijom koristi se razrijeđena otopina SC2 ili jednostavne razrijeđene otopine klorovodične kiseline/razrijeđene dušične kiseline.
-
Stroge zabrane:DHF (diamonijev fluorid) se apsolutno mora izbjegavati kako bi se spriječila korozija staklene podloge.
U cijelom modificiranom procesu, kombiniranje megasonične tehnologije značajno poboljšava učinkovitost uklanjanja nanočestica i nježnije je prema površini.
Zaključak
Procesi čišćenja silicijskih i staklenih pločica neizbježan su rezultat obrnutog inženjeringa na temelju njihovih konačnih zahtjeva za primjenu, svojstava materijala te fizičkih i kemijskih karakteristika. Čišćenje silicijskih pločica teži „atomskoj razini čistoće“ za električne performanse, dok se čišćenje staklenih pločica fokusira na postizanje „savršenih, neoštećenih“ fizičkih površina. Kako se staklene pločice sve više koriste u poluvodičkim primjenama, njihovi procesi čišćenja neizbježno će se razvijati izvan tradicionalnog slabo alkalnog čišćenja, razvijajući profinjenija, prilagođenija rješenja poput modificiranog RCA procesa kako bi se zadovoljili viši standardi čistoće.
Vrijeme objave: 29. listopada 2025.
